EA-H15 红外型BGA返修系统

产品特点
IR红外回流焊系统
红外温度传感器直接检测BGA温度,实现真正闭环控制,保证精确的温度工艺窗口,热分布均匀。
PL精密对位贴放系统
采用可见双色光视觉对位,锡球与焊盘的重合对位科学精准,操控简单,贴放自如。
RPC回流焊监控摄像仪
可以从不同角度观测BGA锡球的熔化过程,为捕捉精确可靠的工艺曲线提供关键性的帮助。
BGASOFT操控软件
连接PC可以记录、控制、分析整个工艺流程,并产生曲线图,满足现代电子工业的制程要求。
CONTROL BOX操控键盘
多功能操作键盘,使连续返修变得更加简便。
加热控温特点
采用暗红外开放式加热,通过非接触式红外温度传感器实时侦测BGA表面温度的变化,实现闭环控制,保证精确的温度工艺窗口,热分布均匀。
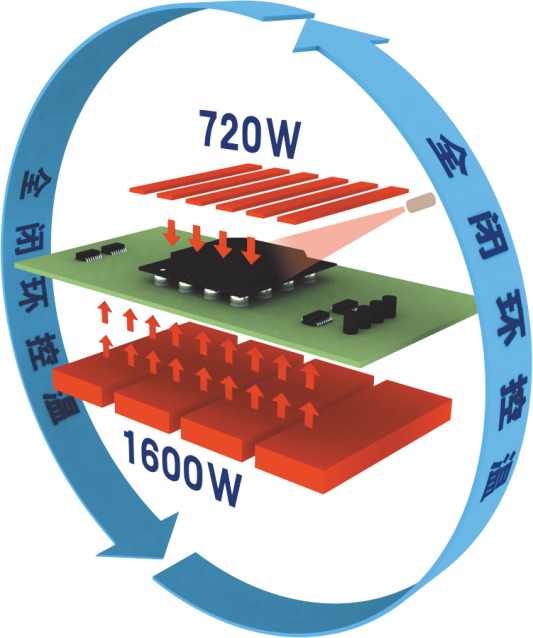
顶部加热器
顶部加热采用功率720W、中等波长(2~8um)的红外加热管加热,可以根据BGA尺寸调整加热窗口的大小。
当流程结束时,内置真空吸杆自动拾取拆除BGA元件,并放置在风扇顶端进行散热。
无需热风罩,节约成本。

底部加热器
采用四组暗红外陶瓷发热盘加热,峰值功率可达1600W;平台尺寸进一步加大,可以对更大尺寸的PCB进行预热,并使PCB受热均匀,防止局部过度加热变形、翘曲。
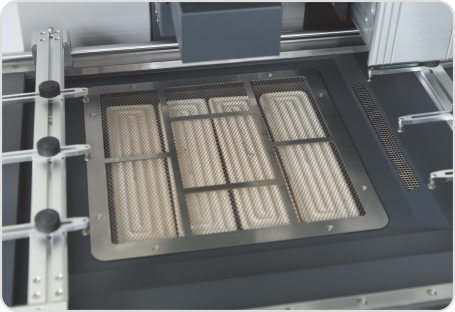
光学棱镜对位
采用光学裂像棱镜对位,BGA锡球照明为蓝色光,PCB焊盘照明为橙色光,灯光可以调节。双色光源通过棱镜折射,BGA锡球、PCB焊盘图像清晰呈现。
通过PL摄像仪图像采集,将锡球和焊盘清晰的显示到监视器中,可通过调整X、Y、Z方向微调旋钮以及0°角控制旋钮,使显示蓝色的锡球和显示橙色的焊盘完全重叠,单击“贴放”一键完成对位作业。
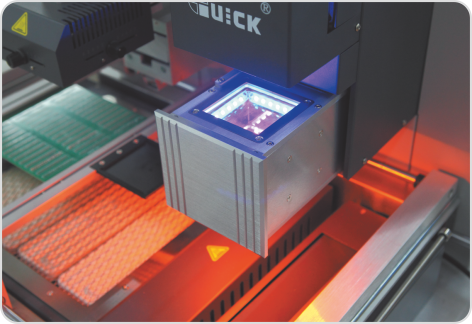
对位调节
对位时可以通过细腻的X、Y、Z、e四个角度的调节,达到最为精准的对位效果。
可轻松应对0.4Pitch器件返修需要。

PCB装夹
不规则线路板可使用不同夹具水平固定,大型线路板底部采用防塌陷支架顶针垂直支撑,以防止变形。
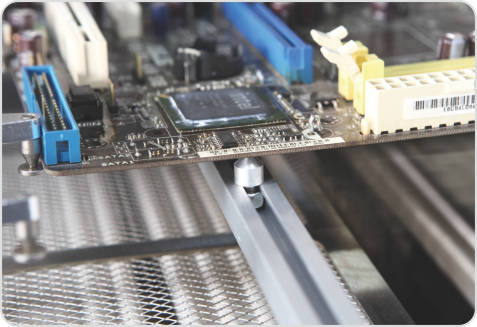
PRPC回流焊监控摄像仪
RPC回流焊监控摄像仪用来侧方位多角度监控回流焊过程中锡球的融化、塌陷以及焊点成型过程。
RPC可以多角度调整移动和观测。
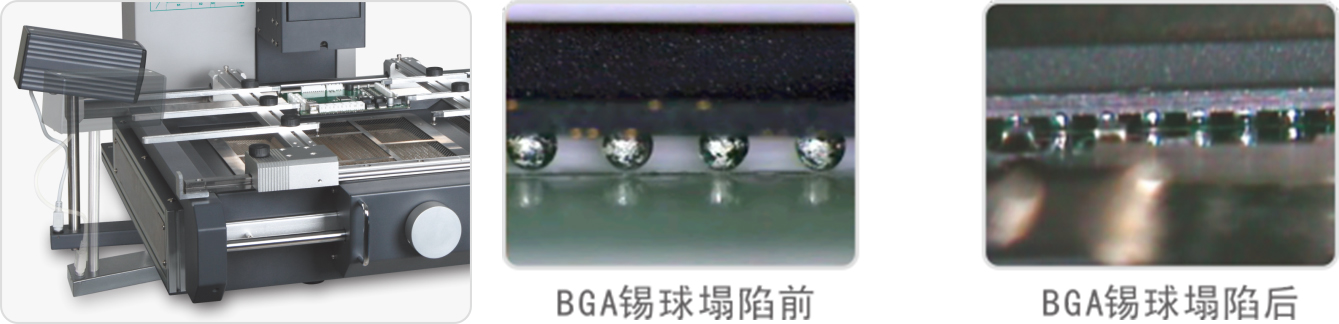
IR 红外回流焊系统
总功率 | 2800W(Max) |
电源 | 220VAC50Hz |
底部预热功率 | 400W*4=1600W(暗红外发热器) |
400W*6=2400W(高红外发热管可选配) |
顶部加热功率 | 120W*6=720W(红外发热管,波长约2~8um) |
顶部加热器尺寸范围 | 20~60mm(X、Y方向均可调) |
底部辐射预热器尺寸 | 290*290mm |
Max线路板尺寸 | 390*420mm |
通讯 | USB(可与PC联机) |
测温传感器 | 非接触式红外 |
重量 | 约90Kg |
外形尺寸(L*W*H) | 850*720*730mm |
PL 精密贴放系统
摄像仪 | 36*12倍放大;24V\300mA;水平清晰度500线;PAL制式 |
棱镜尺寸 | 50mm*50mm |
可返修的BGA尺寸 | 2×2mm~60×60mm |
摄像仪输出信号 | 视频VIDE0信号 |
RPC 回流焊监控摄像仪
摄像仪 | 36*12倍放大 |
水平清晰度500线;PAL制式 |
LED辅助照明 |
CONTROL BOX | 多功能操作键盘 |
采集卡 | 模拟视频输入 |
VIDEO SOFT | 专业视频采集软件 |
BGASOFT是专门针对QUICK EA-H15的控制软件,通过BGASOFT,可以进行温度测试、分析、调整、设置每个流程的温度参数。
BGA的回焊过程通常包括五个阶段:预热、保温、活化、回流、冷却,其中以保温、活化和焊接三个区域的温度和升温速率尤为重要。
预热段:中波暗红外的热量,能够使PCB很好的吸收,保障基础温度均匀。
保温段:消除元件与元件、PCB与元件之间的温差,防止PCB变形和元件损坏。
活化段:让助焊剂充分发挥活性,帮助焊接。
回流段:加热器不断升温达到峰值温度,使BGA锡球充分熔化与焊盘结合,并形成金属间化合物,实现真正焊接。
冷却段:顶部风扇和底部的横流风机,流程结束自动开启散热;降温速率可调 。

软件特色
可以设置登录密码。
可以设置参数保护密码,设定参数修改权限,保证工艺的可靠性。
具有快速上载功能,按“开始”键执行当前指定流程。
具有温度曲线分析功能,可以对存储流程的温度曲线进行工艺的分析研究。
同时可以查看历史工艺参数及温度曲线。可以对工艺曲线进行比较。